芯片外观缺陷检测机
品牌:致茂电子Chroma
型号:7945
产品简介:用于芯片的可靠性老化寿命实验,芯片采用TO/COC封装形式。
相关产品
产品特色
- 双面检测(切割后芯片)
- 异色缺陷检测
- 可选择不同倍率及检测项目以因应不同应用,例如VCSELs、PDs、LEDs、或离散组件(Discrete Devices)
- 支持多计算机检测以缩短处理时间
- 可共享自动进料机设计
- 最大支持8时芯片(10“Hoop Ring)
Chroma 7945制程中芯片外观检查系统为自动化的切割前/后品粒检测设备。切割后品粒可以同时间进行正反两面的品粒外观检查,使用可替换组件设计,能够转换未切割芯片以及金属环或塑料子母环以配合不同应用。
双面检测
对于化合物半导体芯片而言,在切割后产生的背面缺陷,例如剥落及前边是非常严重的。因为缺陷无法于正面看见,使用者必须翻转芯片以及另外进行检测才能获得正反两面的位置分布图,在操作翻面过程中也可能会有品粒翻转损失及合并数据错误的可能。采用同步检测正背面的优点为只需一次扫描,即可得到品粒正反面结果,能大幅减少检测与合并档案时间。
色彩系统
异色检测问题是另一项化合物半导体的重点,因为膜厚不均所造成的颜色不均匀可能会造成检测误判或漏判。检测系统必须拥有待测物彩色信息让用户可以选择高对比度的色彩
频道来建立检测项目,高对比度影像有助于提升检出率。
芯片分布图格式抽屉模组操作
Chroma 7945能够支持不同的芯片分布图格式,例如csv、SEMI XML、SNIF、STIF以及KLARF.用户可以堆栈不同制程的分布图以分析缺陷的成因,或是结合前站测试数
据,并更新分类图以进行下一站挑拣流程。
应用范围
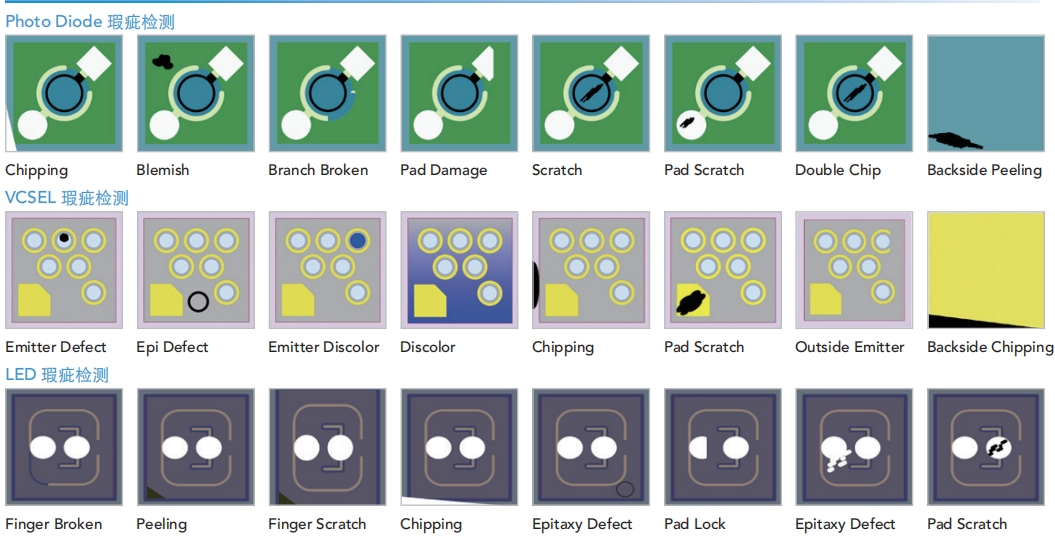
技术参数